Advanced Aging
Key Benefits
- プロセス変動モデルと経年劣化モデルを同時に指定
- ストレス・シミュレーションはノミナルで1回実行すれば、すべての繰り返し作業で再利用可能
- 結果に応じてプロセス変動が経年劣化に与える影響を比較
- 経年解析で自己発熱の独自の計算を柔軟に使用可能
- レイアウト依存効果(LDE)の計算とユーザー定義の劣化モデルをサポート
- BTIリカバリー効果を考慮
- モデルにHCI劣化飽和効果を組み込み
設計者はデバイスの寿命期間中のストレスの影響を高精度で予測する方法を必要としています。予測できなければ、デバイスの劣化により早期に寿命を迎える故障が発生する可能性があります。設計者はデバイス劣化の原因に個別対応するという大変な課題を抱えながら、信頼性解析を使って電気的ストレスに起因するデバイス劣化を評価し、ダイ温度の推定値とプロセス変動の影響に基づいて寿命の短縮を評価してきました。
Cadence® Legato™ Reliability Solutionは、信頼性解析に対する業界初の包括的アプローチを提供します。このソリューションには高度な経年劣化解析が組み込まれており、設計者は、従来の電気的ストレスベースの経年劣化解析、経年による諸効果の予測モデル、ミッション・プロファイルベースの実際のストレス条件、周辺温度でなくデバイス動作温度ベースの経年劣化の加速、ディレーティングの推定値によらないプロセス変動による経年劣化の直接計算など、すべてのデバイス劣化原因を1つの環境で解析できます。
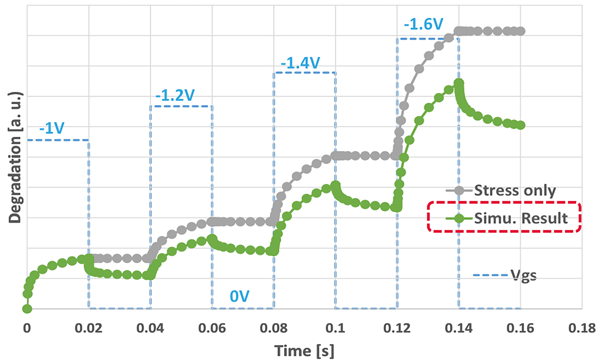
BTIリカバリー効果
レガシーノードやプレーナー型CMOSトランジスタ向けに開発された従来の経年劣化モデルでは、先端ノードやFinFETトランジスタなどの新しいテクノロジの解析は不可能です。Legato Reliability Solutionは、最新のデバイス物理の研究に基づいた新旧のデバイス経年劣化モデルを提供することで、ホットキャリア注入(HCI)やバイアス温度不安定性(BTI)に起因するデバイス劣化の予測精度を向上させたワンストップ・ソリューションです。設計者はLegato™ Reliability Solutionを使って、設計の動作寿命の全期間にわたる高度な経年解析を行い、予測を改善できます。
Blogs VIEW ALL








